エレファンテック、次世代半導体パッケージ向けガラスビア用
銅ナノペースト SAphire™ Gを開発
高AR TGVへの低収縮で高耐久な導体形成を実現、次世代パッケージの普及に貢献
エレファンテック株式会社(本社:東京都中央区、代表取締役社長:清水 信哉)は、独自の自己組織化銅ナノ粒子(SA-CuNP)技術を用いた、ガラス基板貫通ビア(TGV:Through-Glass Via)フィル用銅ナノペースト「SAphire™ G」を開発しました。次世代AI/HPC向けパッケージに期待されているガラス基板において、普及のボトルネックとなっている高アスペクト比(AR)TGVへの低収縮・高耐久な導体形成を実証しており、現在、顧客との共同評価を推進しています。本製品の提供を通じて、次世代半導体パッケージの普及を加速させ、AIの進化に貢献してまいります。
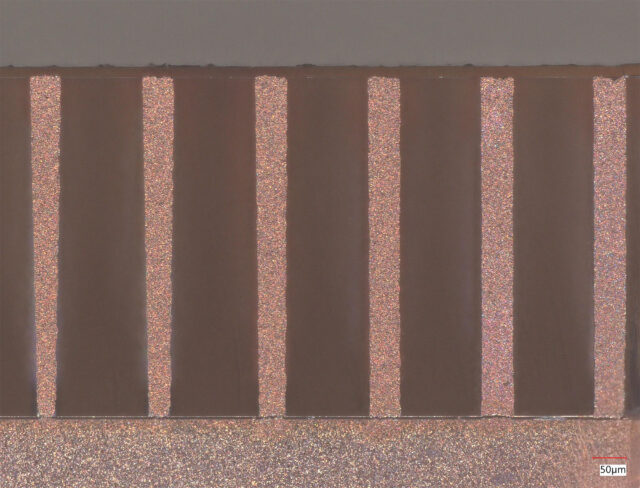 SAphire™ G 充填、焼結、熱衝撃試験後のTGV断面
SAphire™ G 充填、焼結、熱衝撃試験後のTGV断面(Φ50 μm・厚さ0.5 mm、AR=10:1)(マイクロスコープ、×300)
背景
AIアクセラレータ等の高性能化に伴い、半導体パッケージの高密度化・大型化が加速しています。従来の有機基板では、大型化に伴う熱での「反り」や、表面の粗さに起因する微細配線の形成限界といった物理的な課題が顕在化しています。これに対し、シリコンチップに近い熱膨張係数(CTE)と極めて高い表面平滑性を持つガラス基板は、次世代パッケージの有力な土台として期待されています。低誘電損失という特性から高周波信号の伝送効率向上に寄与するほか、将来の光電融合(CPO)技術との親和性も高く、業界から強い注目を集めています。
しかし、その実用化には基板の表裏を電気的に接続する「TGV(ガラス貫通ビア)」の導通形成が不可欠です。特に高密度化に伴う高ARビアへの対応は、信頼性とコストの両面で業界全体の大きなボトルネックとなっており、解決に向けた革新的な手法が強く求められています。
業界におけるTGV導通形成プロセスの検討状況と技術課題
次世代のAI/HPC向けパッケージにおけるTGVの導通形成手法としては、主に「電解めっき(ECP)」と「ペーストフィル」の2つのアプローチが検討されています。しかし、高密度化に伴う高アスペクト比(AR)ビアへの対応において、いずれの手法も量産化に向けた大きな課題を抱えています。
電解めっき法は、低抵抗な導通形成が可能であるという利点を持つ一方、微細化が進む高ARビアの深部まで均一に金属を析出させることが困難であり、ビア奥部への充填不足が導通信頼性を損なう大きな要因となっています。また、数時間単位の長タクトや継続的な液管理が必要という課題も指摘されています。
一方、プロセスが簡便なペーストフィル手法への期待も高まっていますが、既存材料では新たな壁が存在します。一般的な金属焼結ペーストは焼結時の体積収縮が大きく、ビア内に充填したペーストを焼結する過程でボイド(空隙)や隙間が発生しやすいため、高AR環境下での信頼性確保が困難です。また、金属焼結ペーストの中で比較的先行してきた銀(Ag)系材料は銅の約60倍という極めて高い材料コストが量産採用の大きな障壁となってきました。このように、性能・信頼性・コストのすべてを高い次元で両立する革新的な材料が強く求められています。
SAphire™ Gの概要
当社の銅ナノペーストSAphire™シリーズは、15nmクラスの銅ナノ粒子がミクロンサイズの銅粒子表面に自己組織的に吸着し、全体が大きなナノ粒子として機能する独自の「SA-CuNP技術」を基盤としています 。この独自メカニズムにより、ナノ粒子含有量を約10 wt%に抑えつつ優れた低温焼結性を実現。さらに有機分散剤を1 wt%未満まで低減することで、焼結後の不純物残存を最小限に留めています。
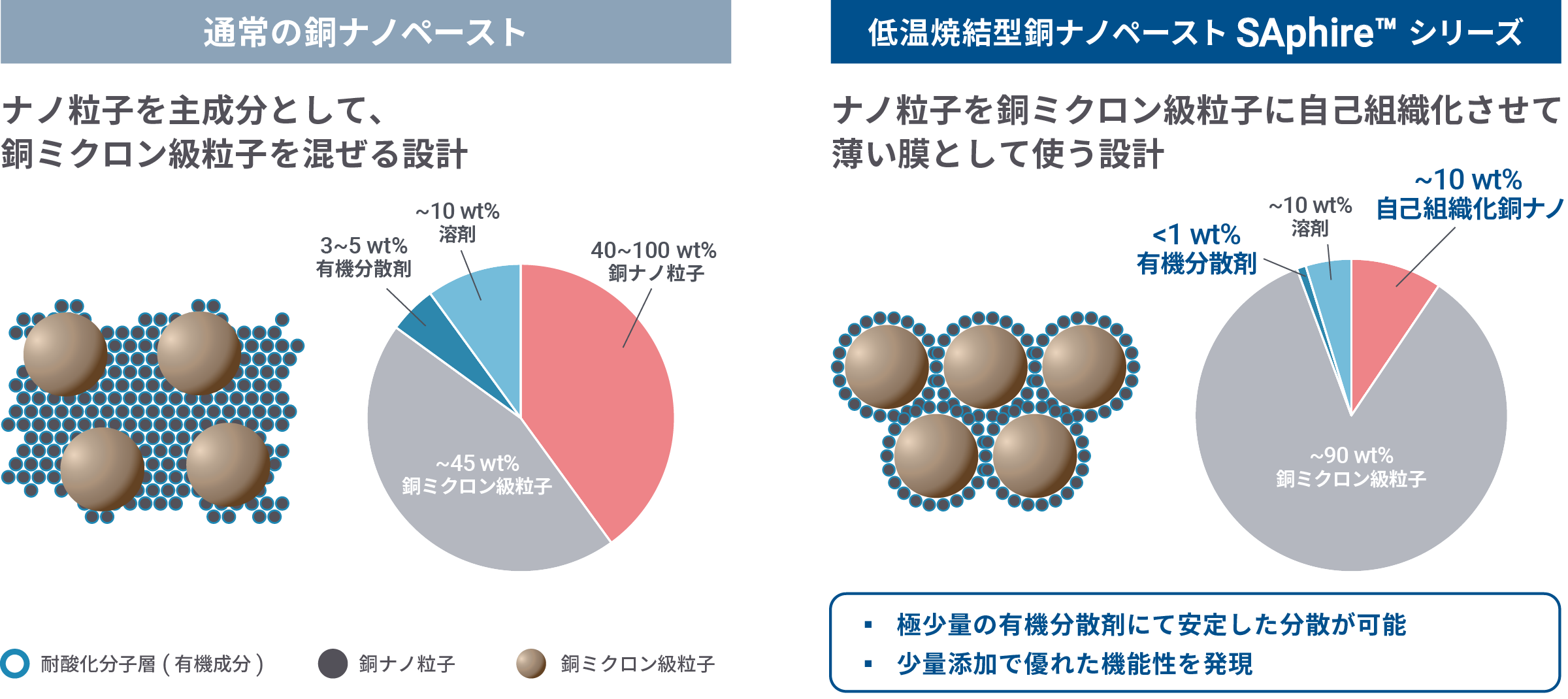
新製品「SAphire™ G」は、この技術をTGVフィル用途に最適化した製品です 。ナノ粒子が少ないことで硬化収縮を大幅に抑え、次世代パッケージが求める高ARビアへのボイドやクラックを抑制した導体形成を実現しました。

本技術の優位性
1. 高ARビアへの高耐久な導体形成
Φ50 μm・厚さ0.5 mm(AR=10:1)のTGVにおいて、緻密な導体形成を実現しました。熱衝撃試験後においてもクラックが発生せず、極めて高い信頼性を有していることを確認しました。
2. 低収縮特性による高品質な充填と高歩留まりの実現
ペーストフィル手法において大きな課題である、焼結時の体積収縮に伴うビア内部のボイドや隙間の発生を抑制しました。この優れた低収縮特性により、高AR環境下でも充填後の導通信頼性を高めるとともに、焼結時の収縮に伴う基材への内部応力を低減します。これにより、物理的に脆い薄型ガラスへのダメージやクラックの発生を抑え、歩留まりを改善する可能性を有しています。
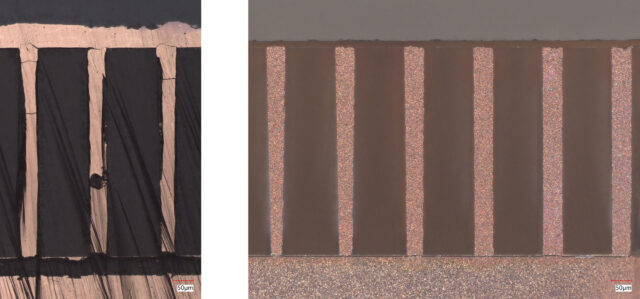
TGV断面比較(マイクロスコープ、×300)
・左:銅ナノ粒子だけで構成された銅ナノペースト(焼結後)・収縮によるボイド多数
・右:SAphire™ Gペースト(焼結、熱衝撃試験後)・熱衝撃試験後でもボイド・クラックなし
※実証サンプルの仕様とワークの処理フロー
・ガラス材料:ホウケイ酸ガラス(TEMPAX Float®)
・ビア仕様:Φ50 μm(AR=10:1)
・処理フロー:等方加圧方式でSA-CuNPペーストを充填 → 300 °C 60分焼結
・信頼性試験:熱衝撃試験(–50 °C ⇔ +125 °C、15分間、250サイクル)を実施
3. 将来的な量産を見据えた経済性の成立
ペーストを充填して焼結するという単純な工程であるため、電解めっき(ECP)プロセスで不可欠な下地(シード層)形成や、高度な液管理を伴う長時間の処理工程が不要となります 。また導電性に優れる銀系材料と比較しても、SAphire™ Gは、材料費を銀の約60分の1に抑えられる銅をベースとしながら、独自の粒子設計により銀系ペーストに匹敵する導電性能のポテンシャルを確保。高性能と経済性を両立した、持続可能な材料サプライチェーンを提案します。
今後の展開
現在「SAphire™ G」は、次世代パッケージの量産化を目指す国内外の基板メーカーやガラスパネルメーカー、および先端パッケージメーカー各社との共同評価フェーズにあります。今後は、AI/HPC向けのガラスコア基板やCPO(Co-Packaged Optics)向けガラスインターポーザー市場をターゲットに、実用化に向けた信頼性検証を加速させてまいります。当社は「Nanomaterials Powering AI Computing」をキーワードに、独自のナノマテリアル技術を通じてAI時代の半導体パッケージ課題の解決に貢献してまいります。
会社概要
| 会社名 | エレファンテック株式会社 |
| 設立 | 2014年1月 |
| 本社所在地 | 104-0032 東京都中央区八丁堀四丁目3番8号 |
| 代表 | 代表取締役社長 清水 信哉 |
| 事業内容 | 製造装置・材料の製造販売、プリント基板の製造販売 |
| URL | https://elephantech.com/ |
エレファンテック株式会社 広報担当 pr@elephantech.co.jp